Показатель преломления и коэффициент экстинкции тонкопленочных материалов - Refractive index and extinction coefficient of thin film materials
А. Р. Форухи и И. Блумер вывели дисперсионные уравнения для показатель преломления, п, и коэффициент экстинкции, k, которые были опубликованы в 1986 г.[1] и 1988.[2] Публикация 1986 г. относится к аморфным материалам, а публикация 1988 г. - к кристаллическим. Впоследствии, в 1991 году, их работа была включена в качестве главы в «Справочник оптических констант».[3] Дисперсионные уравнения Форухи – Блумера описывают, как фотоны различной энергии взаимодействуют с тонкими пленками. При использовании со спектроскопическим рефлектометрия инструмента дисперсионные уравнения Форухи – Блумера задают п и k для аморфных и кристаллических материалов в зависимости от энергии фотонов E. Ценности п и k как функция энергии фотона, E, называются спектрами п и k, которая также может быть выражена как функция длины волны света λ, поскольку E = hc / λ. Символ час представляет собой Постоянная Планка и c, скорость света в вакууме. Все вместе, п и k часто называют «оптическими константами» материала (хотя они не являются константами, поскольку их значения зависят от энергии фотонов).
Вывод дисперсионных уравнений Форухи – Блумера основан на получении выражения для k как функция энергии фотона, символически записываемая как k(E), начиная с первых принципов квантовой механики и физики твердого тела. Выражение для п как функция энергии фотона, символически записываемая как п(E), тогда определяется из выражения для k(E) в соответствии с Отношения Крамерса – Кронига[4] в котором говорится, что п(E) - это Преобразование Гильберта из k(E).
Дисперсионные уравнения Форухи – Блумера для п(E) и k(E) аморфных материалов представлены как:
Пять параметров A, B, C, Eг, и п(∞) каждый из них имеет физическое значение.[1][3] Eг - ширина запрещенной зоны материала в оптическом диапазоне. A, B и C зависят от полосовой структуры материала. Это положительные константы, такие что 4C-B2 > 0. Наконец, n (∞), константа больше единицы, представляет собой значение п в E = ∞. Параметры B0 и C0 в уравнении для п(E) не являются независимыми параметрами, но зависят от A, B, C и Eг. Их дают:
где
Таким образом, для аморфных материалов всего пяти параметров достаточно, чтобы полностью описать зависимость обоих п и k от энергии фотона, Э.
Для кристаллических материалов, которые имеют несколько пиков п и k спектров дисперсионные уравнения Форухи – Блумера могут быть расширены следующим образом:
Количество членов в каждой сумме q равно количеству пиков в п и k спектры материала. Каждый член в сумме имеет свои значения параметров A, B, C, Eг, а также собственные значения B0 и C0. Подобно аморфному случаю, все термины имеют физическое значение.[2][3]
Характеристики тонких пленок
Показатель преломления (п) и коэффициент экстинкции (k) связаны с взаимодействием между материалом и падающим светом и связаны с преломлением и поглощением (соответственно). Их можно рассматривать как «отпечатки пальцев». Покрытия из тонкопленочного материала на различных подложках обеспечивают важные функции для микротехническая промышленность, а п, k, а также толщину, т, из этих тонкопленочных компонентов необходимо измерять и контролировать, чтобы обеспечить повторяемость производство.
Дисперсионные уравнения Форухи – Блумера для п и k первоначально предполагалось, что они будут применяться к полупроводникам и диэлектрикам в аморфном, поликристаллическом или кристаллическом состоянии. Однако было показано, что они описывают п и k спектры прозрачных проводников,[5] а также соединения металлов.[6][7][8][9][10][11][12][13][14][15] Было обнаружено, что формализм для кристаллических материалов применим и к полимерам,[16][17][18] которые состоят из длинных цепочек молекул, не образующих кристаллографической структуры в классическом смысле.
Другие модели дисперсии, которые можно использовать для получения п и k, такие как Tauc-Lorentz, можно найти в литературе.[19][20] Две хорошо известные модели - Коши и Селлмайер - предоставляют эмпирические выражения для п действительны в ограниченном диапазоне измерений и применимы только для непоглощающих пленок, где k= 0. Следовательно, формула Форухи – Блумера использовалась для измерения тонких пленок в различных приложениях.[5][6][7][8][9][10][11][12][13][14][15][16][17][18][19][20]
В следующих обсуждениях все переменные энергии фотонов, E, будет описываться в терминах длины волны света λ, поскольку экспериментальные переменные, связанные с тонкими пленками, обычно измеряются в спектре длин волн. В п и k Спектры тонкой пленки не могут быть измерены напрямую, но должны определяться косвенно из измеряемых величин, которые зависят от них. Спектроскопическая отражательная способность, R (λ), является одной из таких измеримых величин. Другой - спектроскопический коэффициент пропускания, Т (λ), применимо, когда подложка прозрачная. Спектроскопический коэффициент отражения тонкой пленки на подложке представляет собой отношение интенсивности света, отраженного от образца, к интенсивности падающего света, измеренное в диапазоне длин волн, тогда как спектроскопическое пропускание Т (λ), представляет собой отношение интенсивности света, прошедшего через образец, к интенсивности падающего света, измеренное в диапазоне длин волн; как правило, также будет отраженный сигнал, R (λ), сопровождая Т (λ).
Измеряемые величины, R (λ) и Т (λ) зависеть не только от п (λ) и к (λ) пленки, но и от толщины пленки, т, и п (λ) и к (λ) субстрата. Для кремниевой подложки п (λ) и к (λ) значения известны и принимаются в качестве заданных входных данных. Задача описания тонких пленок включает извлечение т, п (λ) и к (λ) пленки из измерения R (λ) и / или Т (λ). Этого можно достичь, объединив дисперсионные уравнения Форухи – Блумера для п (λ) и к (λ) с Уравнения Френеля для отражения и передачи света на границе раздела[21] получить теоретические, физически обоснованные выражения для отражательной способности и пропускания. При этом задача сводится к извлечению пяти параметров A, B, C, Eг, и п (∞) которые составляют п (λ) и к (λ), вместе с толщиной пленки, т, используя нелинейный регрессионный анализ методом наименьших квадратов[22][23] процедура примерки. Процедура подбора влечет за собой итеративное улучшение значений A, B, C, Eг, п (∞), т, чтобы уменьшить сумму квадратов ошибок между теоретическими R (λ) или теоретический Т (λ) и измеренный спектр R (λ) или Т (λ).
Помимо спектрального отражения и пропускания, спектроскопические эллипсометрия может также использоваться аналогичным образом для характеристики тонких пленок и определения т, п (λ) и к (λ).
Примеры измерений
Следующие ниже примеры демонстрируют универсальность использования дисперсионных уравнений Фороуи – Блумера для характеристики тонких пленок с помощью инструмента, основанного на спектроскопической отражательной способности, близкой к нормальному падению. Спектроскопическое пропускание, близкое к нормальному, также используется, когда подложка прозрачна. В п (λ) и к (λ) спектры каждой пленки получаются вместе с толщиной пленки в широком диапазоне длин волн от глубокого ультрафиолета до длин волн ближнего инфракрасного (190–1000 нм).
В следующих примерах обозначения теоретической и измеренной отражательной способности на спектральных графиках выражаются как «R-theor» и «R-Meas», соответственно.
Ниже приведены схемы, изображающие процесс измерения тонких пленок:
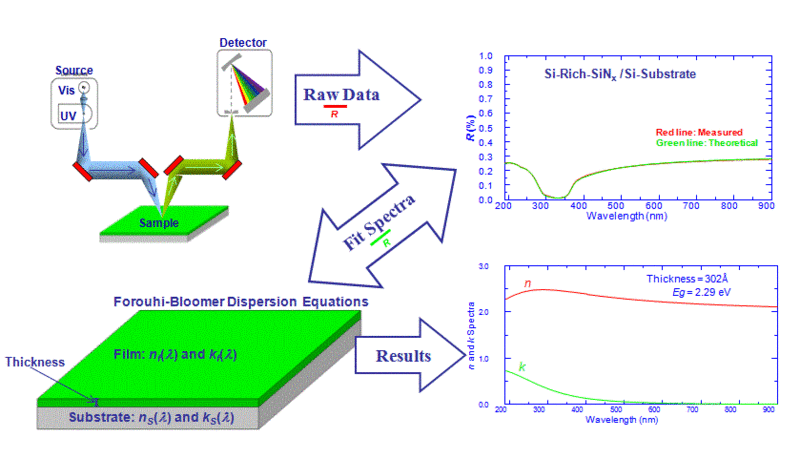
Дисперсионные уравнения Форухи – Блумера в сочетании с Строгий анализ связанных волн (RCWA) также использовались для получения подробной информации о профиле (глубина, CD, угол боковой стенки) траншейных конструкций. Чтобы извлечь информацию о структуре, поляризованные данные широкополосного отражения, Рупий и Rp, должны быть собраны в большом диапазоне длин волн из периодической структуры (решетки), а затем проанализированы с помощью модели, которая включает дисперсионные уравнения Фороуи – Блумера и RCWA. Входные данные в модели включают шаг решетки и п и k спектры всех материалов в структуре, в то время как выходные данные могут включать глубину, компакт-диски в нескольких местах и даже угол боковой стенки. В п и k Спектры таких материалов могут быть получены в соответствии с методологией, описанной в этом разделе для измерений тонких пленок.
Ниже приведены схемы, изображающие процесс измерения траншейных конструкций. Далее следуют примеры измерения траншеи.

Пример 1: Аморфный кремний на окисленной кремниевой подложке (a-Si / SiO2/ Si-Sub)


В примере 1 показан один широкий максимум в п (λ) и к (λ) спектры пленки a-Si, как и ожидалось для аморфных материалов. По мере перехода материала к кристалличности широкий максимум уступает место нескольким более резким пикам. п (λ) и к (λ) спектры, как показано на графиках.
Когда измерение включает две или более пленки в стопке пленок, теоретическое выражение для отражательной способности необходимо расширить, чтобы включить п (λ) и к (λ) спектры плюс толщина, т, каждого фильма. Однако регрессия может не сходиться к уникальным значениям параметров из-за нелинейного характера выражения для отражательной способности. Так что полезно исключить некоторые из неизвестных. Например, п (λ) и к (λ) Спектры одной или нескольких пленок могут быть известны из литературы или предыдущих измерений и удерживаться фиксированными (не могут изменяться) во время регрессии. Чтобы получить результаты, показанные в примере 1, п (λ) и к (λ) спектры SiO2 слой был зафиксирован, а остальные параметры, п (λ) и к (λ) a-Si, плюс толщины как a-Si, так и SiO2 разрешалось варьироваться.
Пример 2: фоторезист 248 нм на кремниевой подложке (PR / Si-Sub)


Полимеры, такие как фоторезист состоят из длинных цепочек молекул, которые не образуют кристаллографической структуры в классическом понимании. Однако их п (λ) и к (λ) спектры показывают несколько острых пиков, а не широкий максимум, ожидаемый для некристаллических материалов. Таким образом, результаты измерений для полимера основаны на формуле Форухи – Блумера для кристаллических материалов. Большая часть структуры в п (λ) и к (λ) спектры происходят в глубоком УФ-диапазоне длин волн, и, таким образом, чтобы должным образом охарактеризовать пленку такого рода, необходимо, чтобы измеренные данные отражения в глубоком УФ-диапазоне были точными.
На рисунке показан пример измерения материала фоторезиста (полимера), используемого для микролитографии с длиной волны 248 нм. Шесть членов использовались в уравнениях Форухи-Блумера для кристаллических материалов, чтобы соответствовать данным и достигать результатов.
Пример 3: Оксид индия и олова на стеклянной подложке (ITO / Glass-Sub)




Оксид индия и олова (ITO) представляет собой проводящий материал с необычным свойством прозрачности, поэтому он широко используется в индустрии плоских дисплеев. Измерения отражения и пропускания стеклянной подложки без покрытия были необходимы для определения ранее неизвестных п (λ) и к (λ) спектры стекла. Затем одновременно измеряли коэффициент отражения и пропускание ITO, нанесенного на одну и ту же стеклянную подложку, и анализировали с помощью уравнений Фороуи-Блумера.
Как и ожидалось, к (λ) спектр ITO равен нулю в видимом диапазоне длин волн, поскольку ITO прозрачен. Поведение к (λ) Спектр ITO в ближнем инфракрасном (NIR) и инфракрасном (IR) диапазонах длин волн напоминает спектр металла: ненулевой в NIR-диапазоне 750–1000 нм (трудно различить на графиках, поскольку его значения очень малы) и достижение максимального значения в ИК-диапазоне (λ> 1000 нм). Среднее k Стоимость пленки ITO в ближнем и инфракрасном диапазоне составляет 0,05.
Пример 4: Мультиспектральный анализ тонких пленок германия (40%) - селена (60%)


При работе со сложными пленками в некоторых случаях параметры не могут быть однозначно разрешены. Чтобы ограничить решение набором уникальных значений, можно использовать метод, включающий мультиспектральный анализ. В простейшем случае это влечет за собой нанесение пленки на две разные подложки и последующий одновременный анализ результатов с использованием дисперсионных уравнений Форухи – Блумера.
Например, однократное измерение коэффициента отражения в диапазоне 190–1000 нм Ge40Se60/ Si не предоставляет уникальных п (λ) и к (λ) спектры фильма. Однако эта проблема может быть решена путем нанесения того же Ge40Se60 пленку на другой подложке, в данном случае окисленном кремнии, и затем одновременно анализируя измеренные данные отражательной способности, чтобы определить:
- Толщина Ge40Se60/ Si пленка на кремниевой подложке как 34,5 нм,
- Толщина Ge40Se60/ Si пленка на окисленной кремниевой подложке как 33,6 нм,
- Толщина SiO2 (с участием п и k спектры SiO2 фиксируется), и
- п и k спектры Ge в диапазоне 190–1000 нм40Se60/ Si.
Пример 5: Сложная конструкция траншеи


Структура траншеи, изображенная на соседней диаграмме, повторяется с интервалами 160 нм, то есть имеет заданный шаг 160 нм. Траншея состоит из следующих материалов:
- M1: Si3N4
- M2: Поли-Si
- M3: Оксид боковины (SiO2)
- M4: SiO2
- M5: Si3N4
- M6: SiO2
- M7: Si субстрат
- M8: Воздух
Точный п и k значения этих материалов необходимы для анализа конструкции. Часто для измерения на образце траншеи присутствует покрытая пленкой, представляющая интерес. В этом примере спектр отражения поликремния был измерен на площади бланкета, содержащей поликремний, из которой он п и k спектры были определены в соответствии с методологией, описанной в этой статье, которая использует дисперсионные уравнения Форухи – Блумера. Фиксированные таблицы п и k значения были использованы для SiO2 и Si3N4 фильмы.
Объединение п и k спектры пленок с Строгий анализ связанных волн (RCWA) были определены следующие критические параметры (в том числе по результатам измерений):
| Измеряемый параметр | Результаты | |
|---|---|---|
| 1 | Si Глубина | 27,4 нм |
| 2 | CD @ Top of Si | 26,4 нм |
| 3 | SiO2 Ширина лайнера | 40,2 нм |
| 4 | Si3N4 Рост | 28 нм |
| 3 | Ширина поли-Si | 92,6 нм |
| 3 | Poly-Si Высота | 85,6 нм |
использованная литература
- ^ а б Forouhi, A.R .; Блумер, И. (1986). «Оптические дисперсионные соотношения для аморфных полупроводников и аморфных диэлектриков». Физический обзор B. 34 (10): 7018–7026. Bibcode:1986ПхРвБ..34.7018Ф. Дои:10.1103 / Physrevb.34.7018. PMID 9939354.
- ^ а б Forouhi, A.R .; Блумер, И. (1988). «Оптические свойства кристаллических полупроводников и диэлектриков». Физический обзор B. 38 (3): 1865–1874. Bibcode:1988ПхРвБ..38.1865Ф. Дои:10.1103 / Physrevb.38.1865.
- ^ а б c Forouhi, A.R .; Блумер, И. (1991). Палик, Э. (ред.). Справочник оптических констант II. Академическая пресса. п. Глава 7.
- ^ Роман, П. (1965). Продвинутая квантовая теория. Эддисон-Уэсли.
- ^ а б Торкаман, Н.М .; Ganjkhanlou, Y .; Каземзад, М .; Dabaghi, H.H .; Кианпур-Рад, М. (2010). «Кристаллографические параметры и электрооптические константы в тонких пленках ITO». Характеристики материалов. 61 (3): 362–370. Дои:10.1016 / j.matchar.2009.12.020.
- ^ а б Lakhdar, M.H .; Оуни, Б .; Амлук, М. (2014). «Влияние толщины на структурные и оптические константы тонких пленок стибнита, полученных сульфидным отжигом пленок сурьмы». Optik - Международный журнал световой и электронной оптики.
- ^ а б Аль-Ханбаши, H.A .; Shirbeeny, W .; Al-Ghamdi, A.A .; Бронштейн, L.M .; Махмуд, W.E. (2014). "Спектроскопическая эллипсометрия тонких пленок Zn1-xCuxO на основе модифицированной техники золь-гель покрытия погружением". Spectrochimica Acta Часть A: Молекулярная и биомолекулярная спектроскопия. 118: 800–805. Bibcode:2014AcSpA.118..800A. Дои:10.1016 / j.saa.2013.09.085. PMID 24157332.
- ^ а б Накамура, Т .; Moriyama, T .; Набатова-Габаин, Н .; Адачи, С. (2014). «Скорость затухания излучения светового излучателя на тонких металлических пленках». Японский журнал прикладной физики. 53 (4): 5201. Bibcode:2014JaJAP..53d5201N. Дои:10.7567 / jjap.53.045201.
- ^ а б Winkler, M.T .; Wang, W .; Gunawan, O .; Hovel, H.J .; Тодорова, Т.К .; Митци, Д. (2014). «Оптические конструкции, повышающие эффективность солнечных элементов Cu2ZnSn (S, Se) 4». Энергетика и экология. 7 (3): 1029–1036. Дои:10.1039 / c3ee42541j.
- ^ а б Miao, L .; Су, Л.Ф .; Tanemura, S .; Fisher, C.A.J .; Zhao, L.L .; Liang, Q .; Сюй, Г. (2013). «Экономичные нанопористые покрытия SiO2 – TiO2 на стеклянных подложках с антиотражающими и самоочищающимися свойствами». Прикладная энергия. 112: 1198–1205. Дои:10.1016 / j.apenergy.2013.03.043.
- ^ а б Zhang, F .; Zhang, R.J .; Zhang, D.X .; Wang, Z.Y .; Xu, J.P .; Zheng, Y.X .; Chen, L.Y .; Huang, R.Z .; Sun, Y .; Чен, X .; Мэн, X.J.; Дай, Н. (2013). «Температурно-зависимые оптические свойства тонких пленок оксида титана, исследованные методом спектроскопической эллипсометрии». Прикладная физика Экспресс. 6 (12): 121101. Bibcode:2013APExp ... 6l1101Z. Дои:10.7567 / apex.6.121101.
- ^ а б Sheng-Hong, Y .; Sen, C .; Ning, Y .; Юэ-Ли, З. (2013). «Оптическое исследование золь-гель-обработанных мультиферроидных пленок BiFeO3, легированных неодимом, методом спектроскопической эллипсометрии». Сегнетоэлектрики. 454 (1): 78–83. Дои:10.1080/00150193.2013.842802.
- ^ а б Балакришнан, Г .; Сундари, S.T .; Kuppusami, P .; Chandra, P.M .; Srinivasan, M.P .; Mohandas, E .; Ganesan, V .; Састикумар, Д. (2011). «Исследование микроструктурных и оптических свойств нанокристаллических тонких пленок церия, полученных методом импульсного лазерного осаждения». Тонкие твердые пленки. 519 (8): 2520–2526. Bibcode:2011TSF ... 519.2520B. Дои:10.1016 / j.tsf.2010.12.013.
- ^ а б Cheng, K.W .; Huang, C.M .; Pan, G.T .; Chang, W.S .; Lee, T.C .; Ян, T.C.K. (2010). «Влияние Sb на рост и фотоэлектрохимический отклик пленочных электродов AgIn5S8, созданных методом выращивания в растворе». Химическая инженерия. 65 (1): 74–79. Дои:10.1016 / j.ces.2009.02.002.
- ^ а б Das, N.S .; Ghosh, P.K .; Mitra, M.K .; Чаттопадхьяй, К. (2010). «Влияние толщины пленки на ширину запрещенной зоны нанокристаллических тонких пленок CdS, анализируемое методом спектроскопической эллипсометрии». Physica E: низкоразмерные системы и наноструктуры. 42 (8): 2097–2102. Bibcode:2010PhyE ... 42.2097D. Дои:10.1016 / j.physe.2010.03.035.
- ^ а б Xiong, K .; Hou, L .; Wang, P .; Xia, Y .; Chen, D .; Сяо, Б. (2014). «Повышенная эффективность фосфорного легирования в двухслойных органических солнечных элементах за счет большей длины диффузии экситонов». Журнал Люминесценции. 151: 193–196. Bibcode:2014JLum..151..193X. Дои:10.1016 / j.jlumin.2014.02.016.
- ^ а б Huynh, T.P .; Pietrzyk-Le, A .; Чандра-Бикрам, К.С.; Noworyta, K.R .; Sobczak, J.W .; Sharma, P.S .; D'Souza, F .; Катнер, В. (2013). "Электрохимически синтезированный молекулярно отпечатанный полимер производных тиофена для определения аденозин-5'-трифосфата (АТФ) методом проточного инжекционного анализа". Биосенсоры и биоэлектроника. 41: 634–641. Дои:10.1016 / j.bios.2012.09.038. PMID 23131778.
- ^ а б Zhu, D .; Shen, W .; Ye, H .; Лю, X .; Чжэнь, Х. (2008). "Определение оптических констант полимерных светоизлучающих диодных пленок по измерениям однократного отражения". Журнал физики D: Прикладная физика. 23. 41 (23): 235104. Bibcode:2008JPhD ... 41w5104Z. Дои:10.1088/0022-3727/41/23/235104.
- ^ а б Laidani, N .; Bartali, R .; Gottardi, G .; Anderle, M .; Чейссак, П. (2008). "Параметры оптического поглощения аморфных углеродных пленок из моделей Форухи – Блумера и Таука – Лоренца: сравнительное исследование". Журнал физики: конденсированное вещество. 20 (1): 15216. Bibcode:2008JPCM ... 20a5216L. CiteSeerX 10.1.1.369.5532. Дои:10.1088/0953-8984/20/01/015216.
- ^ а б Ишваракхантан, Т .; Beyssen, D .; Brizoual, L.L .; Алнот, П. (2007). "Оптические дисперсии Форухи – Блумера и Таука – Лоренца, применяемые с помощью спектроскопической эллипсометрии к плазменно-осажденным фторуглеродным пленкам". Журнал прикладной физики. 101 (7): 073102–073102–7. Bibcode:2007JAP ... 101g3102E. Дои:10.1063/1.2719271.
- ^ Небеса, О.С. (1965). Оптические свойства тонких твердых пленок.. Нью-Йорк: Дувр.
- ^ Левенберг, К. (1944). «Метод решения некоторых нелинейных задач наименьших квадратов». Ежеквартальный вестник прикладной математики. 2 (2): 164. Дои:10.1090 / qam / 10666.
- ^ Марквардт, Д.В. (1963). "Алгоритм оценки нелинейных параметров методом наименьших квадратов". Журнал Общества промышленной и прикладной математики. 2. 11 (2): 431–441. Дои:10.1137/0111030. HDL:10338.dmlcz / 104299.




![C_ {0} = { frac {A} {Q}} left [({E_ {g}} ^ {2} + C) { frac {B} {2}} -2E_ {g} C правильно]](https://wikimedia.org/api/rest_v1/media/math/render/svg/eaa9b806311c61380349a55d22e33a8a3e740e47)

![k (E) = sum _ {{i = 1}} ^ {q} left [{ frac {A_ {i} (E-E _ {{g_ {i}}}) ^ {2}} {E ^ {2} -B_ {i} E + C_ {i}}} right]](https://wikimedia.org/api/rest_v1/media/math/render/svg/6ded4534ad3d3003a0d41ad0cd80fa21ae5ac1a2)
![n (E) = n ( infty) + sum _ {{i = 1}} ^ {q} left [{ frac {B _ {{0_ {i}}} E + C _ {{0_ {i}} }}} {E ^ {2} -B_ {i} E + C_ {i}}} right]](https://wikimedia.org/api/rest_v1/media/math/render/svg/8ab26d2f5af8be8b2ee137b52012ca9ef199ffe4)